집적회로 실패분석
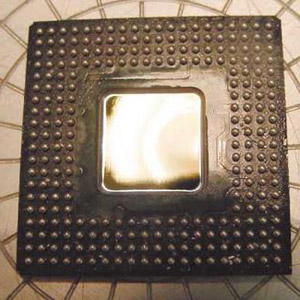
실패 분석(FA) 기술은 집적회로 결함의 원인을 인식하고 그 위치를 찾는데 사용됩니다.
응용노트 요청FA 응용에서 박막 두께 측정이 필요한 2가지의 주요 유형은 front side delayering공정(고전적인 device-side up 회로 패키지)와 backside thinning (새로워진 flip-chip device-side down 회로 패키지)공정입니다.
Front Side Delayering
front side delayering 공정은 유전체 thinning후 유전체 두께의 정보가 필요 합니다.
Backside FA
Backside FA는 중요한 각각의 thinning 스텝 후에 잔여 Si의 두께를 알고 회로망이 형상화되기 전 대부분의 Si die 두께를 제거하는데 필요 합니다. Filmetrics F3-sX시스템은 특히 backside thinning 공정 후 거친 Si층들의 두께를 측정 하도록 설계 되었습니다. 5µm~1000µm 두께는 쉽게 측정되며 최소 두께가 0.1µm 이하는 옵션으로 확장 가능합니다. 모두 single spot과 매핑 버전이 가능 합니다.
고객님의 반도체 결함분석 응용분야에 관하여 자사의 박막(Thin Film) 전문가들에게 문의하시기 바랍니다.
Filmetrics는 무상의 샘플 측정을 제공 합니다 - 결과는 보통 1-2일 안에 가능 합니다.
지금 저희에게 문의 바랍니다
응용분야 찾기
-
비정질(Amorphous) & 폴리실리콘
결정질과 비결정질 실리콘의 두께, 결정도, 굴절률, 흡수율 측정 하기.
APPLICATIONS_amorphous-poly-silicon_FilterKeywords
-
CMP
자사의 F80 두께 이미지 제품은 oxide, STI, 그리고 금속 CMP 공정에 사용 되어 집니다.
APPLICATIONS_cmp_FilterKeywords
-
유전체
Filmetrics는 산업계에서 두루 사용 되는 수천개의 유전체 필름을 측정 하기 위한 장비를 보유 하고 있습니다.
APPLICATIONS_dielectrics_FilterKeywords
-
하드코팅 두께
Filmetrics 시스템은 하드코팅과 primer 두께를 검증하기 위해 자동차 산업에서 폭 넓게 사용 합니다.
APPLICATIONS_hardcoat-thickness_FilterKeywords
-
IC 실패분석
F3-sX는 실리콘 backside thinning을 측정 하기 위해 chip 업계에서 고루 사용 하고 있습니다.
APPLICATIONS_failure-analysis_FilterKeywords
-
ITO & 기타 TCOs
소유의 분석 알고리즘은 TCO 두께, 굴절률, 흡수율의 한번의 클릭으로 가능 하게 합니다.
APPLICATIONS_ito_FilterKeywords
-
금속 장치
Meangioplasty balloons, stent 와 implant 코팅 그리고 많은 다른 것들의 두께 측정 하기.
APPLICATIONS_biomedical_FilterKeywords
-
금속두께 측정
50nm까지 두꺼운 금속 필름의 두께, 굴절률, 흡수율을 측정 하세요.
APPLICATIONS_metal_FilterKeywords
-
OLEDs
NPB, AlQ3, PEDOT, P3HT, soluble Teflons 등의 굴절률을 측정 하세요
APPLICATIONS_oled_FilterKeywords
-
안과코팅
반사율과 컬러 측정 및 AR과 하드코팅 층 두께 측정을 위해 F10-AR을 사용 하세요.
APPLICATIONS_ophthalmic_FilterKeywords
-
파릴렌코팅
단순히 두께 측정을 위해서 F3-CS의 stage에 페럴린 코팅된 샘플을 올려 놓으세요!
APPLICATIONS_parylene_FilterKeywords
-
포토리지스트
자사는 수십여개의 다른 리지스트를 측정 해 왔으며 귀하가 사용하는 어떤 리지스트도 생성 할수 있습니다.
APPLICATIONS_photoresist_FilterKeywords
-
다공성 실리콘(Porous Silicon)
귀하의 다공성 실리콘 필름의 두께, porosity, 굴절률과 흡수율 측정 하기.
APPLICATIONS_porous-silicon_FilterKeywords
-
공정 필름
Filmetrics는 반도체 공정 필름을 측정을 위한 범용의 제품을 제공 합니다.
APPLICATIONS_process-films_FilterKeywords
-
굴절률 & 흡수율
190-1700nm 만큼 넓은 영역의 파장 대역에서 굴절률, 흡수율 측정 하기.
APPLICATIONS_refractive-index_FilterKeywords
-
실리콘웨이퍼& 막(Membranes)
자사는 2mm까지 두꺼운 실리콘을 측정 하는 탁사용, 매핑, 양산 시스템을 제공 합니다.
APPLICATIONS_si-wafers_FilterKeywords
-
태양광 응용
CdTe, CdS, CIGS, 비정질(amorphous)-Si, TCOs, 비반사(AR)층 측정하기 , 그리고 그 이상...
APPLICATIONS_solar_FilterKeywords
-
반도체 교육랩
50여개 이상의 Filmetrics의 F20 시스템이 대학교 강의 랩에서 사용 되고 있습니다.
APPLICATIONS_teaching-labs_FilterKeywords
-
웹코팅
Filmetrics 시스템은 in-line 두께를 측정 하기 위해서 고분자 필름 계열에 널리 사용 되어 집니다.
APPLICATIONS_web-coatings_FilterKeywords